AlOx基高性能忆阻器研究新进展
当今,忆阻器已成为下一代非易失性存储器及非冯存算一体化技术的有利候选。其中,过渡金属氧化物(包括氧化铪,氧化钽,氧化钨等)由于其成本低、操作速度快、功耗低、耐擦写、3维集成能力和CMOS兼容工艺等优势,已成为最有潜力的忆阻材料。在非晶态氧化物的电阻转变机理研究方面,已有大量文献研究表明是在介质层中连接上下电极的氧空位导电丝的形成与熔断。然而,大量报道的氧化物忆阻器仍然存在差异性大(循环间C2C和器件间D2D的一致性),脉冲擦写能力及存储窗口不足等问题。
在各种氧化物中,氧化铝(AlOx)材料具有在900℃下维持稳定的非晶态以及高介电常数等性质,有利于器件实现低操作电流、稳定的擦写与保持,以及宽温区工作特性。
我们采用了射频溅射和原子层沉积两种工艺制备双层不同氧含量的氧化铝薄膜,基于该方法获得了W/AlOx(RF)/AlOy(ALD)/Pt忆阻器。该器件呈现出高阻态一致性(C2C:σ/μ<0.12)、大脉冲擦写窗口(>100)、高擦写速度与次数(20 ns,107次)、稳定保持特性(125℃下高低阻态各保持104s),以及多位存储(3-bit)的能力。结合电学量测分析及高分辨电镜手段,我们证实该方法相比于单层忆阻器更趋于形成局域化的氧空位导电细丝,从而改善器件各项性能参数。成果近日发表于Applied Physics Letters,博士生黄晓弟为第一作者,由李祎副教授和缪向水教授共同指导完成。

图1.(a)器件的直流开关耐久性测试;(b)在交替的SET(1.5 V,20ns)和RESET(-1.75 V,20 ns)脉冲下,器件达到107次循环开关;(c)通过改变复位脉冲电压实现3 bit阻态循环调控;(d)在0.1 V下对3 bit阻态的读操作测试。
为探究器件尺寸微缩对性能的影响,我们采用了电子束光刻工艺制备了特征尺寸为250 nm的双层氧化铝W/AlOx(RF)/Al2O3 (ALD)/Pt忆阻器。我们发现,器件呈现出forming-free的电阻转变行为,从而解决传统氧化物忆阻器中需要较大初始化电压的难题。此外,器件还展现出高速(28 ns)、大脉冲擦写开关比(~103@100K, ~103@298K, and ~80@400K)、2值存储、良好保持等优良性能。结果进一步证实了双层氧化物结构能够有效改善器件性能。特别的是,器件能够在宽温区下实现稳定的电阻转变行为,分别在100K,298K,和400K的温度下连续擦写了108,1010,107次,为器件在高低温环境应用中奠定了初步基础。成果近日发表于IEEE Electron Device Letters,博士生黄晓弟为第一作者,由李祎副教授和缪向水教授共同指导完成。
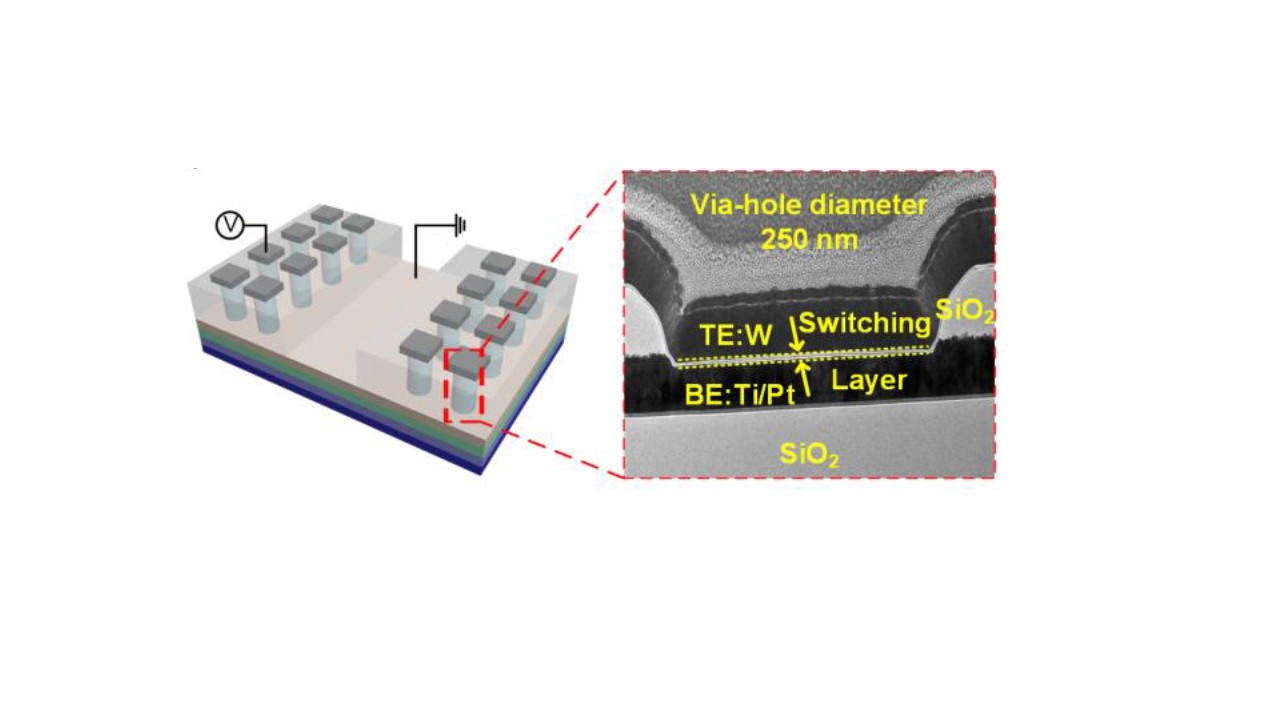
图2. 250 nm特征尺寸的双层AlOx器件结构示意图与TEM截面图
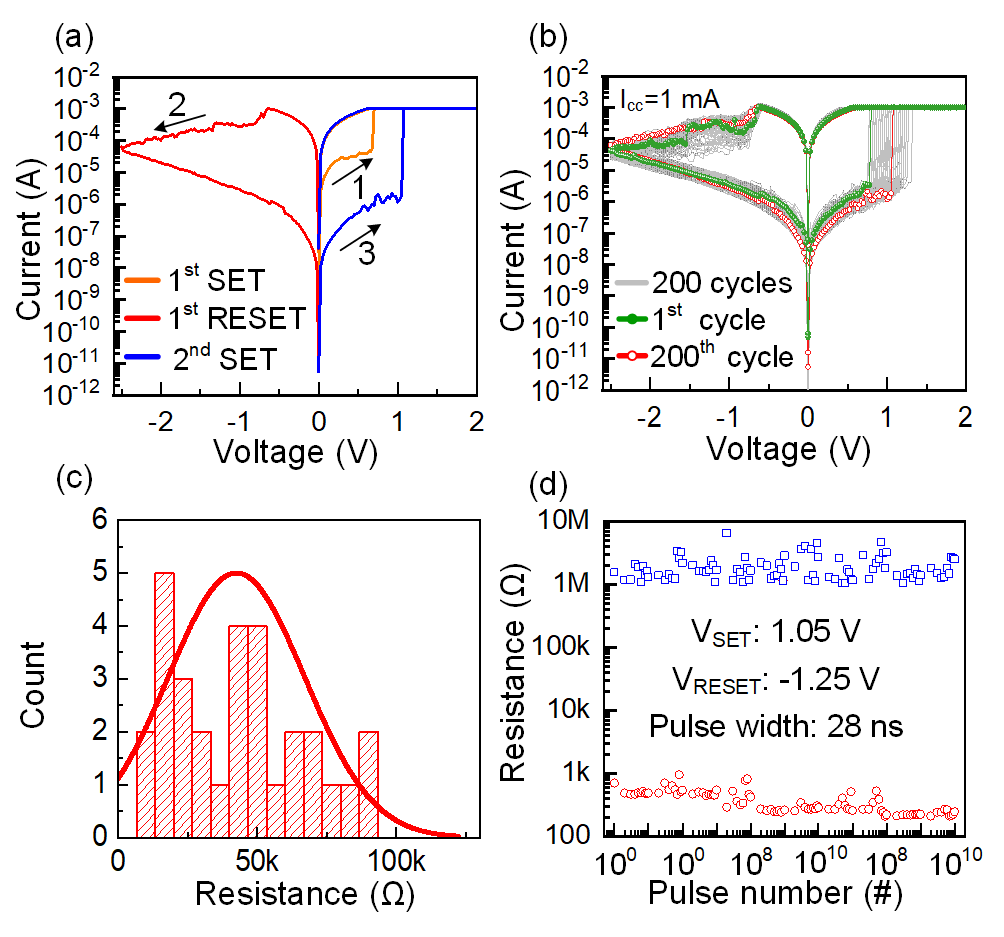
图3.(a)器件展现forming-free的阻变行为;(b)直流下I-V阻变曲线;(c)30个器件的初始电阻值的分布;(d)在室温下具有超过1010个循环的脉冲擦写能力。
相关论文:
1. X. D. Huang, Y. Li,* H.Y. Li, Y. F. Lu, K. H. Xue, and X. S. Miao, Appl. Phys. Lett. 116, 173504, (2020).
论文链接:https://aip.scitation.org/doi/10.1063/5.0006850
2. X. D. Huang, Y. Li,* H. Y. Li, K. H. Xue, X. Wang and X. S. Miao, IEEE Electron Device Letters. vol. 41, no. 4, pp. 549-552 (2020).
论文链接:https://ieeexplore.ieee.org/document/9019885

